
Ионная имплантация
|
Начальная О предприятии Лопатки ГПА Паровые лопатки Прототипирование Специальная обработка ИПА |
|
ИИ |
|
ВПП ПХП ИЛ ВТО ЭПО УЗО Оборудование НИР Экспертная оценка Арматура Контакты |
 |
|
СОДЕРЖАНИЕ
|
|
 |
СУЩНОСТЬ ИОННОЙ ИМПЛАНТАЦИИ
Ионная имплантация - это процесс, в котором практически любой элемент может быть внедрен в приповерхностную область любого твердого тела - мишени, помещенной в вакуумную камеру, посредством пучка высокоскоростных ионов с энергией до нескольких мегаэлектронвольт. Имплантируемые ионы внедряются в материал мишени на глубину от 0,01 до 1 мкм, формируя в ней особое структурно-фазовое состояние. Толщина слоя зависит от энергии и от массы ионов и от массы атомов мишени.
Так как технология имплантационного модифицирования позволяет внедрить в поверхность заданное количество практически любого химического элемента на заданную глубину, то таким образом можно сплавлять металлы, которые в расплавленном состоянии не смешиваются, или легировать одно вещество другим в пропорциях, которые невозможно достичь даже при использовании высоких температур. Следовательно, оказалось возможным создавать композиционные системы с уникальными структурами и свойствами, существенно отличными от свойств основной массы детали.
Как объект атомно-физических исследований ионная имплантация впервые сформировалась в начале 60-х годов. Это стало возможным благодаря достижениям в области изучения ядерных взаимодействий; основным оборудованием для ионного легирования является ускоритель. Энергия ионов может изменяться (в зависимости от свойств материалов комбинации ион - мишень) от нескольких килоэлектронвольт (кэВ) до нескольких мегаэлектронвольт (МэВ). Введение импланта в основную решетку поверхности изделия возможно без “соблюдения” законов термодинамики, определяющих равновесные процессы, например, диффузию и растворимость.
Ионная имплантация приводит к значительному изменению свойств поверхности по глубине:
слой с измененным химическим составом до 1-9 мкм;
слой с измененной дислокационной структурой до 100 мкм.
Так как технология имплантационного модифицирования позволяет внедрить в поверхность заданное количество практически любого химического элемента на заданную глубину, то таким образом можно сплавлять металлы, которые в расплавленном состоянии не смешиваются, или легировать одно вещество другим в пропорциях, которые невозможно достичь даже при использовании высоких температур. Следовательно, оказалось возможным создавать композиционные системы с уникальными структурами и свойствами, существенно отличными от свойств основной массы детали.
Как объект атомно-физических исследований ионная имплантация впервые сформировалась в начале 60-х годов. Это стало возможным благодаря достижениям в области изучения ядерных взаимодействий; основным оборудованием для ионного легирования является ускоритель. Энергия ионов может изменяться (в зависимости от свойств материалов комбинации ион - мишень) от нескольких килоэлектронвольт (кэВ) до нескольких мегаэлектронвольт (МэВ). Введение импланта в основную решетку поверхности изделия возможно без “соблюдения” законов термодинамики, определяющих равновесные процессы, например, диффузию и растворимость.
Ионная имплантация приводит к значительному изменению свойств поверхности по глубине:
МЕХАНИЗМ МОДИФИЦИРОВАНИЯ ПОВЕРХНОСТИ
Сталкиваясь с электронами и ядрами мишени, ионы легирующего вещества на некоторой глубине теряют энергию и останавливаются. Если известны тип и энергия ионов и свойства обрабатываемого материала, то глубина проникновения (или длина пробега) может быть вычислена. Для пучков с типичными энергиями от 10 до 500 кэВ величина пробега достигает одного мкм. Как уже указывалось, вследствие влияния большого числа факторов, эпюра распределения внедренного вещества в поверхность близка по форме гауссовскому распределению (рис.1). Внедрение ионов в кристаллическую решетку обрабатываемого материала приводит к появлению дефектов структуры (рис.1). Выбитые из узлов решетки атомы вещества приводят к образованию вакансий и дефектов структуры в виде внедренных межузельных атомов. Эти же дефекты возникают при застревании между узлами решетки ионов. Скопление таких дефектов образует дислокации и целые дислокационные скопления (рис.2).
Общая разупорядоченность кристаллического строения (вплоть до перехода вещества в аморфное состояние) решетки при ионной бомбардировке называется радиационным повреждением. Исследования показывают, что радиационные повреждения могут изменить в положительную сторону механические, электрические и другие свойства металла поверхностного слоя, но могут и снижать эксплуатационные свойства деталей. В последнем случае делается отжиг; температурная активация ускоряет перестройку атомов, что приводит к более высокой термодинамической стабильности упорядоченной кристаллической решетки
Для изменения эпюры распределения имплантированных атомов по глубине поверхностного слоя применяют варьирование энергии ионного пучка и числа ионов, попадающих в мишень, как это показано на рисунке 3. Пунктирными линиями показаны эпюры распределения ионов азота, имплантированного в железо пучками различных энергий; при этом каждая последующая обработка выполняется пучком большей энергии. Результирующая концентрация ионов имплантированного вещества получается достаточно однородной при некоторой толщине слоя.
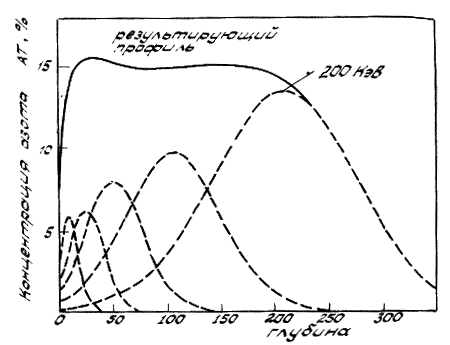
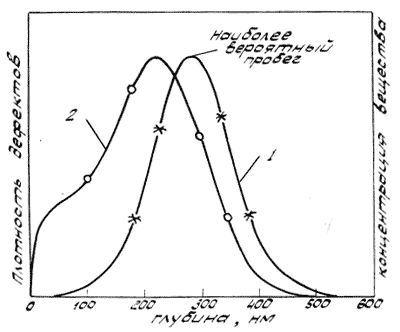 |
 |
|
Распределение ионов легирующего вещества (1) и дефектов кристаллической решетки (2) по глубине модифицированного поверхностного слоя
|
1 - атомы подложки; 2 - ионы имплантируемого вещества; 3 - образующиеся вакансии; 4 - пути движения иона; 5 - атом подложки, застрявший в межузельном пространстве; 6 - пути движения выбитых атомов из узлов решетки; 7 - атом мишени, удаляемый распылением с поверхности.
Модель изменения кристаллического строения вещества и химического состава подложки при бомбардировке ее ускоренными ионами |
Общая разупорядоченность кристаллического строения (вплоть до перехода вещества в аморфное состояние) решетки при ионной бомбардировке называется радиационным повреждением. Исследования показывают, что радиационные повреждения могут изменить в положительную сторону механические, электрические и другие свойства металла поверхностного слоя, но могут и снижать эксплуатационные свойства деталей. В последнем случае делается отжиг; температурная активация ускоряет перестройку атомов, что приводит к более высокой термодинамической стабильности упорядоченной кристаллической решетки
Для изменения эпюры распределения имплантированных атомов по глубине поверхностного слоя применяют варьирование энергии ионного пучка и числа ионов, попадающих в мишень, как это показано на рисунке 3. Пунктирными линиями показаны эпюры распределения ионов азота, имплантированного в железо пучками различных энергий; при этом каждая последующая обработка выполняется пучком большей энергии. Результирующая концентрация ионов имплантированного вещества получается достаточно однородной при некоторой толщине слоя.
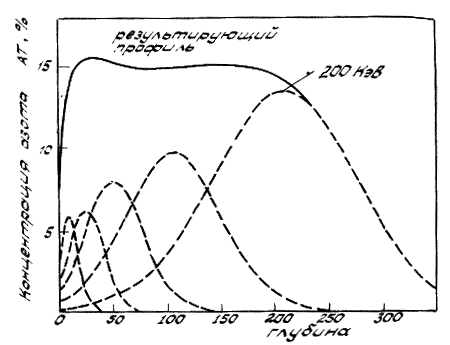
Эпюры распределения концентрации ионов азота, имплантированного в железо пучками различных энергий
 подробнее о
подробнее ометодах обработки
УПРОЧНЕНИЕ ДЕТАЛЕЙ
Изначально ионная имплантация применялась в микроэлектронике для изготовления больших интегральных схем. С развитием вакуумной техники и появлением сильноточных ионных источников стало возможным проводить модификацию поверхности крупногабаритных изделий. В настоящее время разработанные на нашем предприятии технологии ионной имплантации позволяют обрабатывать рабочие лопатки паровых турбин максимальным габаритом до 1700 мм.
Достигнуто:Увеличение предела усталости на 7-25 %;
Повышение долговечности более чем в 20 раз;
Улучшение структуры поверхностного слоя деталей;
Повышение адгезионной прочности последующих покрытий;
При нанесении защитных покрытий на турбинные лопатки из жаропрочных сплавов тиа ЦНК достигнуто повышение:
жаростойкости в 2,5 раза,
коррозионной стойкости в 1,9 раза
длительной прочности в 1,6 раза
сопротивления усталости в 1,2 раза
Достигнуто:
При нанесении защитных покрытий на турбинные лопатки из жаропрочных сплавов тиа ЦНК достигнуто повышение:
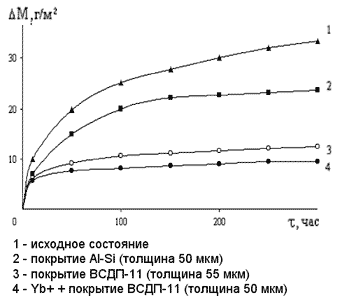 |
 |
|
Потеря массы образцов из сплава ЦНК7П
в процессе испытания на жаростойкость после различных видов обработки |
Длительная прочность образцов из сплава ЦНК7П
(нагрузка 350МПа, температура 850 ОС на воздухе) |
